PN结
前置知识
半导体
元素周期表左侧的金属元素组成导体。金属导体可以导电,因为金属元素原子最外层的电子容易挣脱原子核的束缚,并在外电场的作用下产生定向移动,这样就可以形成电流。而绝缘体中的电子很难自由移动,因此表现为导电性极差。
半导体中原子核对电子的束缚能力既没有绝缘体那么强,也没有导体那么弱,因此其导电性位于导体与绝缘体之间。
本征半导体的导电机理
将硅、锗等元素制成纯净的单晶体,就得到本征半导体。其中,极少数电子在常温下由于热运动而激发为自由电子,从而在共价键中留下一个空位置(空穴)。正因如此,本征半导体中的自由电子与空穴总是数目相等。
在外电场的作用下,(热运动激发产生的)自由电子与空穴定向移动,从而产生电流。
杂质半导体
将本征半导体进行掺杂,即可得到杂质半导体。
P型半导体
P型半导体是硅晶体掺杂微量的+3价元素(往往是铟或铝)形成的,而+3价元素相较于硅缺少一个电子,因此P型半导体的晶体结构中存在“空穴”。
N型半导体
N型半导体是硅晶体掺杂微量的+5价元素(往往是砷、磷、锑等)形成的,而+5价元素相较于硅缺多一个电子,因此N型半导体的晶体结构中存在自由电子。
空穴、自由电子均可作为“载流子”,让电流流过。因此,通过控制掺杂的浓度,就可以控制杂质半导体的导电性能。对于P型半导体,其自由电子数目远多于空穴数目,因此称自由电子为“多子”,空穴为“少子”;相应地,称N型半导体中的空穴为多子,自由电子为少子。
其他术语
扩散运动:由于粒子浓度差而产生的总体的运动趋势
漂移运动:在电场力的作用下,载流子的运动
非平衡少子:
平衡少子:
多子:掺杂产生的载流子
少子:本征发产生的载流子
PN结
PN结由P型半导体与N型半导体组成。P型半导体与N型半导体的交接面形成PN结。
PN结的形成机理
由于扩散作用,在P型半导体与N型半导体的界面附近,自由电子与空穴会自发地结合。
随着扩散与结合的进行,界面处不断消耗P型半导体的自由电子,从而离界面稍远侧的P型半导体逐渐开始显正电性;相应地,离界面稍远侧的N型半导体逐渐开始显负电性。
于是,在界面附近就会产生内电场,阻碍P型半导体中的自由电子向N侧扩散,以及N型半导体中的空穴向P侧扩散。
在不考虑少子的情况下,随着内电场强度的增加,扩散会最终停止(本质是一种动态平衡),并在PN结附近形成既不含有空穴、也不含有自由电子的空间电荷区,也叫耗尽区。
- 掺杂浓度越高,耗尽区宽度越窄
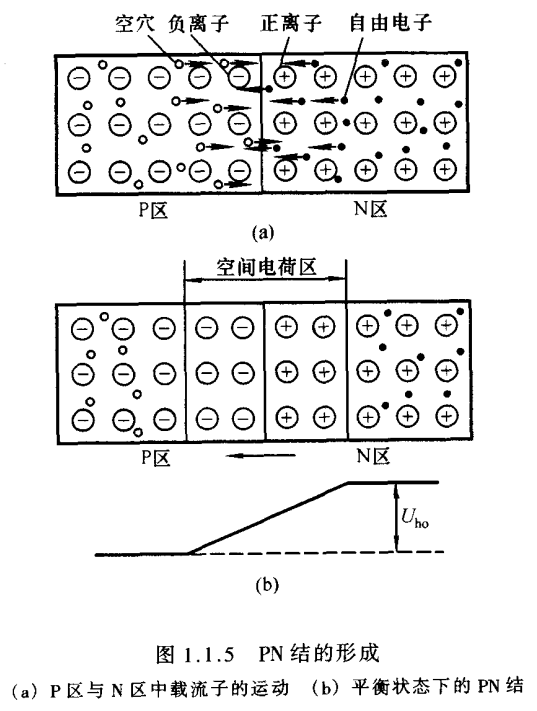
[^PN结的形成]: 图片来自童诗白 华成英《模拟电子技术基础 第四版》P13
更准确地说,当耗尽区不再扩大时,其中不再含有掺杂产生的多子,而只有类似本征激发而产生的少子。少子在内电场作用下会向耗尽区边缘移动。在耗尽区不再扩大时,参与扩散的多子与耗尽区的少子在耗尽区达到动态平衡。
PN结的正向导电
给PN结的P型半导体接上电源正极,N型半导体接上电源负极,称PN结外加正向电压,也叫正向偏置。
在PN结外加正向电压时,外电场方向与内电场方向相反,因此自由电子与空穴有会被外电场“推向”耗尽区的趋势。如果外电场在空间电荷区产生的电场强度大于内电场强度,空间电荷区的总体电场方向改变,自由电子与空穴的“结合”将在两种半导体的交接面持续进行,从而形成正向电流。
个人分析理解:因此,可以说,PN结的正向导电机理是两种载流子在两种半导体的交接面持续地“湮灭”产生的。
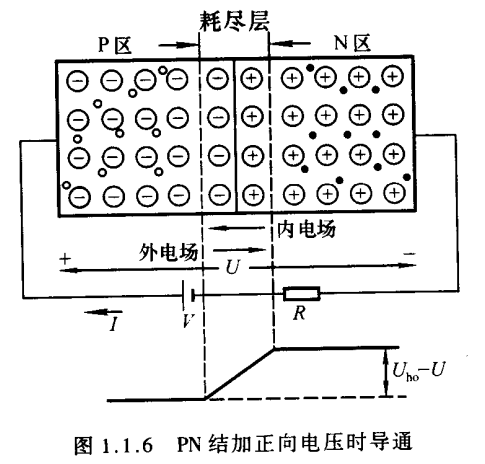
[^PN结的正向导通]: 图片来自童诗白 华成英《模拟电子技术基础 第四版》P14
PN结的反向截止
给PN结的P型半导体接上电源负极,N型半导体接上电源正极,称PN结外加反向电压,也叫反向偏置。
在PN结外加反向电压时,外电场方向与内电场方向相同,因此自由电子与空穴会被外电场“推向”远离界面的两侧,从而耗尽层将进一步扩大。
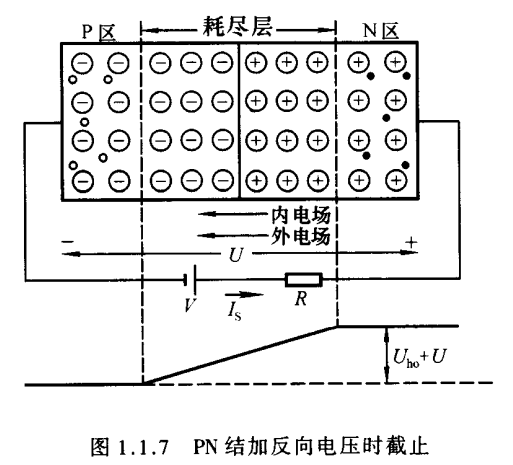
[^PN结的反向截止]: 图片来自童诗白 华成英《模拟电子技术基础 第四版》P15
个人分析理解:换一种角度理解,以P区为例,尽管P区还有空穴,但是由于P区显负电性,对电子具有排斥的倾向,因此尽管有外加电源,其中的空穴仍不会全部与电子湮灭。
当反向电流足够大时,PN结也可以发生反向击穿。根据二极管的掺杂浓度等特性的不同,可能发生齐纳击穿或雪崩击穿。
下文简单概括了两种击穿的机理。
齐纳击穿
如果半导体的掺杂浓度较高,其耗尽层很窄,那么很小的电压就能在耗尽区感应出很强的电场,从而直接破坏共价键,产生电子-空穴对。
齐纳击穿本质上是靠电场力来破坏共价键的。
雪崩击穿
如果半导体的掺杂浓度较低,其耗尽层很宽,那么在反向电压较低时就不会产生齐纳击穿。在反向电压较高时,耗尽层中的少子会在电场中被加速,从而带有很高的能量,能够把价电子撞出共价键,形成电子-空穴对。被撞出来的价电子又会撞出更多的电子,从而使得载流子“雪崩”式地增加。
雪崩击穿本质上是靠电子动能来破坏共价键的。
PN结的电容效应
待补充
常用的晶体管元件
二极管
略去
稳压二极管
稳压二极管在反向击穿的时候,在一定的电流范围,其两端电压几乎不变。我们常在稳压电源等电路中利用它的这个性质。

[^稳压二极管]: 图片来自童诗白 华成英《模拟电子技术基础 第四版》P24
图[^稳压二极管] (a)展示了稳压二极管的伏安特性曲线,可见其反向击穿时的曲线十分陡峭。
图[^稳压二极管] (b)展示了稳压二极管的等效电路。
- 接入正向电压或反向电压未击穿时,其可以等效为二极管D
1 - 反向击穿时,其可以等效为D
2、Uz、rd的串联电路,其中D2为理想二极管(无内阻,正向击穿电压为0V,反向不导电),Uz为电压源- 当D
2左侧电压高于右侧(即反向电压高于Uz)时,D2正向导通 - D
2导通后,电流每增加$\Delta i$,等效电路两端电压增加$\Delta i \times r_d$,由于$r_d$很小,因此等效电路两端电压增加不大
- 当D
晶体三极管
结构
使用不同的掺杂方式在同一个硅片上制造出三个掺杂区域,从而形成两个PN结,这样就构成了晶体三极管。
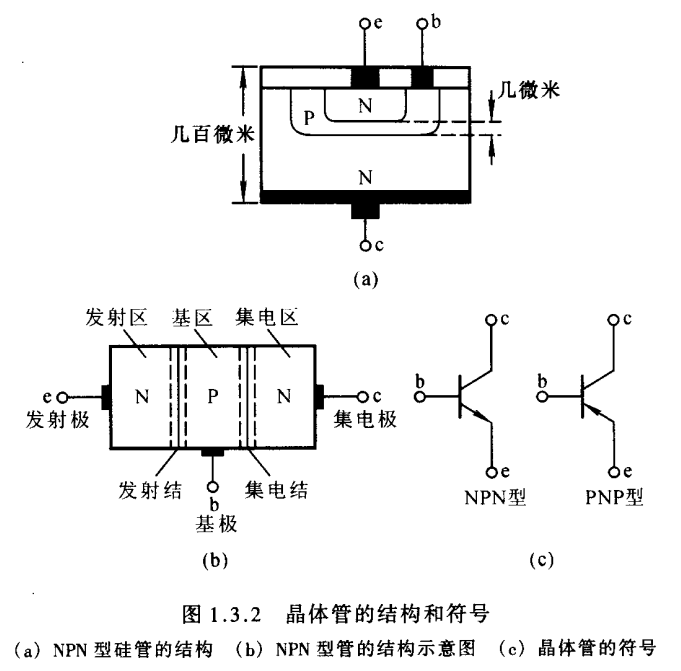
[^晶体三极管]: 图片来自童诗白 华成英《模拟电子技术基础 第四版》P29
图[^晶体三极管]展示了晶体三极管的结构与符号。如图[^晶体三极管] (a)所示,位于中间的区域称为基区,它很薄且掺杂浓度很低;位于上层的区域是发射区,掺杂浓度很高;位于下方的区域是集电区,其面积很大。
由于基区掺杂浓度低,且发射区掺杂浓度高,因此,由于扩散运动,有大量自由电子越过发射结到达基区。
这三个区域引出三个电极:基极(b, base)、发射极(e, emitter)、集电极(c, collector)
个人分析理解:三极管符号中的箭头方向指向发射结(基区与发射区形成的PN结)正向导通的电流方向。
功能
三极管是一种使用电流控制电流的元件,其鲜明的特征是具有对电流的放大作用。
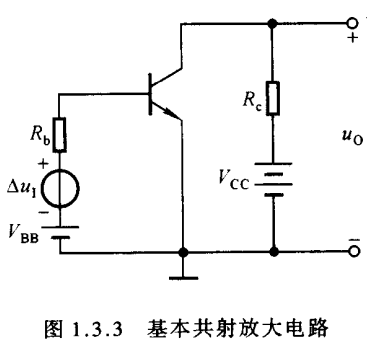
[^基本共射放大电路]: 图片来自童诗白 华成英《模拟电子技术基础 第四版》P29
图片[^基本共射放大电路]展示了使用NPN三极管的基本共射放大电路。其中,基极-发射极回路被称作输入回路;集电极-发射极回路被成为输出回路。
在此电路中,$\Delta u_1$是被放大的信号,被放大后的信号为$u_0$。
由于发射极是两个回路的公共端,因此这种电路被称作共射放大电路。
原理
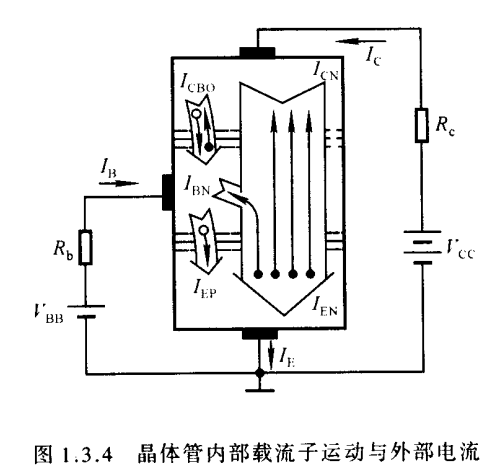
[^三极管内部原理]: 图片来自童诗白 华成英《模拟电子技术基础 第四版》P30
图[^三极管内部原理]展示了正常工作的三极管内部载流子的运动。图中,三极管左侧电极为基极,三极管下侧电极为发射极,三极管上部电极为集电极。
内部电流机理
在图[^三极管内部原理]展示的接法中:
- 三极管发射结被施加正向电压,由于基区掺杂浓度低、发射区掺杂浓度高,且受电场力作用,因此有大量发射区载流子越过发射结到达基区(主要,扩散运动与漂移运动共同作用),以及少量基区载流子越过发射结到达发射区(次要,漂移运动),形成发射极电流$I_E$。
- 图中基区载流子的漂移运动产生的电流为$I_{EP}$,发射区载流子扩散运动产生的电流为$I_{EN}$
- $I_E = I_{EP} + I_{EN}$
- 在电场力作用下,从发射区扩散到基区的非平衡“少子”不断与基区载流子复合(主要)以及少量基区载流子越过发射结到达发射区和集电区(次要,漂移运动),形成**基极电流$I_B$**。由于基区掺杂浓度低,这部分电流较小。
- 从发射区扩散到基区的非平衡“少子”不断与基区载流子复合产生的电流为$I_{BN}$
- 载流子越过集电结的漂移运动产生的电流为$I_{CBO}$
- 载流子越过发射结的漂移运动产生的电流为$I_{EP}$
- $I_B + I_{CBO} = I_{BN} + I_{EP}$,一般情况下$I_B \gg I_{CBO}$,因此将$I_B + I_{CBO}$记作$I’_B$
- 由于基区的掺杂浓度低,发射区扩散至基区的基区非平衡“少子”不会全部与基区的载流子复合,大部分会在电场力的作用下越过集电结并进入集电区(主要,漂移运动),基区的其他载流子也会越过集电结进入集电区(次要,漂移运动),形成**集电极电流$I_C$**。
- 发射区扩散至基区的基区非平衡“少子”在电场力的作用下越过集电结并进入集电区产生的电流为$I_{CN}$
- 基区的平衡少子越过集电结进入集电区产生的电流为$I_{CBO}$
- $I_C = I_{CBO} + I_{CN}$
计算
在图[^三极管的内部原理]所示的电路中,我们容易得出,在三极管外部,$I_E=I_B+I_C$.
我们记电流$I_{CN}$与$I’B$之比为**共射直流电流放大系数$\overline{\beta}$**,于是有
$$
\overline{\beta} = \frac{I{CN}}{I’B} = \frac{I_C - I{CBO}}{I_B + I_{CBO}}
$$
整理可得$I_C = \overline{\beta}I_B + (1 + \overline{\beta})I_{CBO}$,记$I_{CEO} = (1+\overline{\beta})I_{CBO}$,于是有$$I_C = \overline{\beta}I_B + I_{CEO} \tag{1}$$,我们称$I_{CEO}$为穿透电流。
- 当基极开路(即$I_B = 0$)时,$I_C = I_E = I_{CEO}$,因此穿透电流$I_{CEO}$的物理意义为基极开路时集电结的反向饱和电流
- 当发射极开路(即$I_E = 0$)时,$I_{EP} = I_{EN} = 0$,容易看出电流$I_{CBO}$是发射极开路时集电结的反向饱和电流
由于通常情况$I_B \gg I_{CBO}$因此有$I_C \approx \overline{\beta}I_B$,从而有
$$
I_E \approx (1 + \overline{\beta})I_B \label{my_eq}
$$
因此,称三极管为电流控制元件。
总结
- 发射区掺杂浓度高;基区很薄且掺杂浓度低
- 正常工作时,发射结被施加正向电压,集电结被施加反向电压
- 发射极电流与基极电流大致成倍数关系
场效应管
场效应管(FET, Field Effect Transistor)是利用输入回路的电场效应来控制输出回路电流的一种半导体器件。此类元件仅依靠半导体中的多数载流子导电,因此也称作单极型晶体管。
结型场效应管
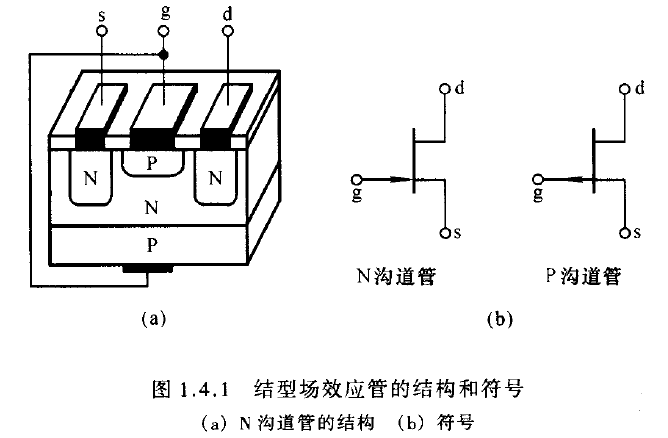
[^结型场效应管结构]: 图片来自童诗白 华成英《模拟电子技术基础 第四版》P40
图[^ 结型场效应管结构] (a)展示了N沟道的结型场效应管的结构示意图。其中,两块P区半导体掺杂浓度高,它们连在一起作为栅极(g, gate);两块N区半导体作为漏极(d, drain)和源极(s, source)。
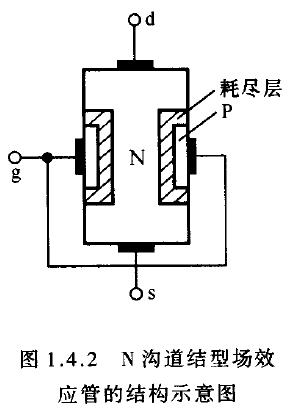 [^N沟道结型场效应管结构示意图]
[^N沟道结型场效应管结构示意图]
为便于理解,使用图[^N沟道结型场效应管结构示意图]来更清晰地说明。
原理
在结型场效应管正常工作时,图[^N沟道结型场效应管结构示意图]中阴影部分的耗尽层承受反向电压。我们通过控制栅极-源极电压$|u_{GS}|$、栅极-漏极电压$|u_{DS}|$实现对导电沟道的控制。
源极、漏极短路,即$u_{DS} = 0V$时,$u_{GS}$对导电沟道的控制作用

[^源极漏极短路时的导电沟道]: 图片来自童诗白 华成英《模拟电子技术基础 第四版》P41
图[^源极漏极短路时的导电沟道]展示了$u_{DS} = 0V$时,$u_{GS}$对导电沟道的控制作用。如图所示,随着$|u_{GS}|$的增大,耗尽层逐渐变宽,导电沟道逐渐变窄,直至$|U_{GS}|$增大到某一个数值,导电沟道完全消失,此时源极与漏极的电阻趋于无穷大。我们称此时$|u_{GS}|$的数值为夹断电压$U_{GS(off)}$。
$|u_{GS}|$在0V到$U_{GS(off)}$之间时,$u_{DS}$对导电沟道的控制作用
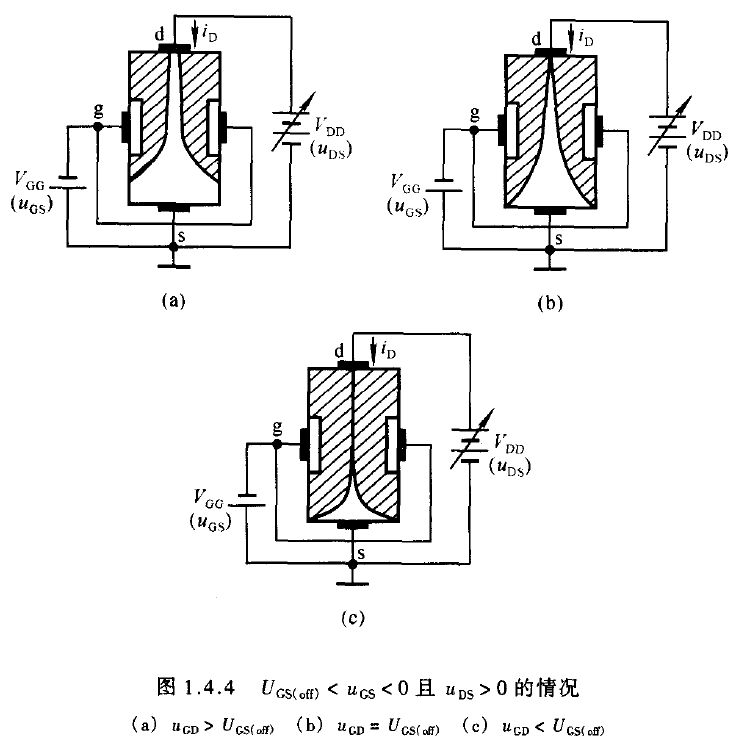
[^源极-漏极电压对导电沟道的影响]:图片来自童诗白 华成英《模拟电子技术基础 第四版》P42
当$|u_{GS}| \neq 0V$时,沟道中的电压不再处处相等,栅极g与漏极d的电压差最大,如图[^源极-漏极电压对导电沟道的影响]的电路接法所示,因此靠近漏极一侧的耗尽区更宽,导电沟道更窄。
根据图中的电路,容易得出:
$$
|u_{GD}| = |u_{DS}| + |u_{GS}| \label{ugd_eq}
$$
- $|u_{DS}|$小于$|U_{GS(off)}|$时,随着$|u_{DS}|$的增大,$|u_{GD}|$增大,漏极d一侧的耗尽层变宽,导电沟道变窄,如图[^源极-漏极电压对导电沟道的影响] (a)所示
- 沟道未夹断时,沟道的电阻基本由$|u_{GS}|$决定,因此漏极电流大小$|i_d|$随着$|u_{GS}|$增大而增大
- 我们称此工作区为可变电阻区(非饱和区)
- 直至**$|u_{GD}|$达到$|U_{GS(off)}|$,此时导电沟道在漏极d一侧被夹断,如图[^源极-漏极电压对导电沟道的影响] (b)所示,我们称这种情况为预夹断**
- 沟道夹断后,$|u_{GS}|$越大,夹断区越长,沟道的电阻也随之增大
- 由式$\eqref{ugd_eq}$,此时$|u_{DS}| = |u_{GS}| - |U_{GS(off)}|$
- $|u_{GD}|$大于$|U_{GS(off)}|$时,随着$|u_{DS}|$的进一步加大,夹断区开始加长,如图[^源极-漏极电压对导电沟道的影响] (c)所示
- 随着$|u_{DS}|$增大,源极s与漏极d之间的电场强度增大,而根据式$\eqref{ugd_eq}$,$|U_{GD}|$也随之增大,即夹断区对电荷移动造成的阻力增大,两种趋势互相抵消
- 预夹断后,$|u_{GS}|$增大,漏极电流$|i_d|$几乎不变,此时表现出恒流特性
- 当$|u_{DS}|$确定时,对于给定的$|u_{GS}|$,就有确定的$|i_{d}|$
- 我们称此工作区为恒流区(饱和区)
- $|u_{GS}| \gt |U_{GS(off)}|$时,靠近源极s一侧的导电沟道也已被夹断,如图[^N沟道结型场效应管结构示意图] (c)所示,即使$|u_{DS}| = 0V$,导电沟道也完全被夹断
- 我们称此工作区为夹断区
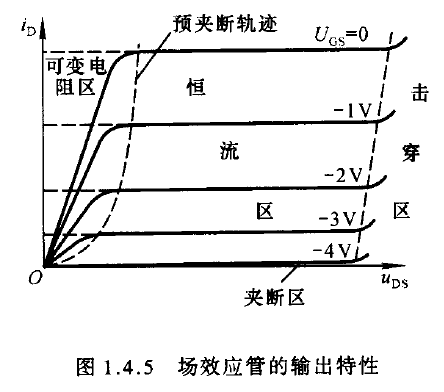 [^场效应管的输出特性]
[^场效应管的输出特性]
[^场效应管的输出特性]: 图片来自童诗白 华成英《模拟电子技术基础 第四版》P43
因此,我们称场效应管为电压控制元件,因为其源极-漏极电流是受到源极-栅极电压控制的。
总结
栅极g半导体掺杂浓度高
耗尽层承受反向电压
栅极-漏极耗尽层更宽;栅极-源极耗尽层较窄
定性地看:
- 源极-漏极电压固定时,源极-栅极电压绝对值越大,源极-漏极的导电能力就越差
- 源极-栅极电压固定时,源极-漏极电压绝对值越大,源极-漏极的导电能力就越差
结型场效应管的几个工作区
MOS管
MOS管全称金属氧化物半导体场效应管(MOS, Metal Oxide Semiconductor FET),其中“氧化物”指栅极与半导体之间的二氧化硅绝缘层。
相较于结型场效应管,MOS管的栅极与半导体基板之间被SiO2隔开,因此其栅极-源极电阻较结型场效应管更大。MOS管被广泛应用在大规模集成电路中。
参考文献
[^源极-漏极电压对导电沟道的影响]: 图片来自童诗白 华成英《模拟电子技术基础 第四版》P42
[^N沟道结型场效应管结构示意图]: 图片来自童诗白 华成英《模拟电子技术基础 第四版》P40